超低速イオンの透過型電子顕微鏡用試料作製への応用
「浮遊型低速イオン銃の開発」でも述べた通り、近年の半導体デバイスの微細化技術の発展に伴い、シャロードーパント半導体など次世代のデバイス作製技術が不可欠となってきています。作製したデバイスの評価として、デバイスの深さ分析だけでなく、デバイス構造を原子レベルで観察することも非常に重要となります。今後のデバイス作製では、デバイスの多層膜構造などを原子レベルで制御することが不可欠となります。膜自身や膜間の界面などを原子レベルで観察する手法として、現在でも透過型電子顕微鏡(TEM)が広く用いられています。
TEMを用いたデバイスの界面等の観察では、試料断面を観察するために、断面TEM用の試料を作製する必要があります。TEM観察では電子線が試料を透過する必要があるため、試料の厚さはおおよそ数十nm以下に薄片化しなければなりません。近年では、デバイス上の観察したい部分を任意に選択して観察可能な収束イオンビーム(FIB)を用いた断面TEM試料作製法が広く用いられています。しかしながら、FIBで用いられるイオンのエネルギーは数十keVと非常に高く、作製した断面TEM試料表面に厚さ数nmのアモルファス層、いわゆるダメージ層を形成してしまいます。ダメージ層で覆われた試料をTEM観察すると、像の劣化を引き起こしてしまいます。
そこで私たちは、このダメージ層を最終加工段階で除去し、より正確な断面観察を行うために、私たちが開発した「浮遊型低速イオン銃」を応用することを試みています。
図1、2は、断面TEM試料作製へ超低速イオンビームを応用した結果の一例です。試料はSi(111)ウエハーをへき開して作製したものです。
TEMを用いたデバイスの界面等の観察では、試料断面を観察するために、断面TEM用の試料を作製する必要があります。TEM観察では電子線が試料を透過する必要があるため、試料の厚さはおおよそ数十nm以下に薄片化しなければなりません。近年では、デバイス上の観察したい部分を任意に選択して観察可能な収束イオンビーム(FIB)を用いた断面TEM試料作製法が広く用いられています。しかしながら、FIBで用いられるイオンのエネルギーは数十keVと非常に高く、作製した断面TEM試料表面に厚さ数nmのアモルファス層、いわゆるダメージ層を形成してしまいます。ダメージ層で覆われた試料をTEM観察すると、像の劣化を引き起こしてしまいます。
そこで私たちは、このダメージ層を最終加工段階で除去し、より正確な断面観察を行うために、私たちが開発した「浮遊型低速イオン銃」を応用することを試みています。
図1、2は、断面TEM試料作製へ超低速イオンビームを応用した結果の一例です。試料はSi(111)ウエハーをへき開して作製したものです。
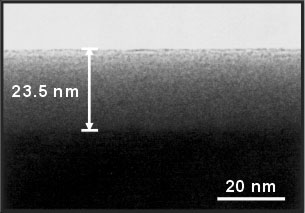
図1. FIB加工によりダメージ層を導入したSiの断面TEM像
用いたイオンは25keV、Ga+
Matsutani et al., J. Surf. Anal. 7, 314 (2000).
用いたイオンは25keV、Ga+
Matsutani et al., J. Surf. Anal. 7, 314 (2000).
図1は、Si試料にFIB装置により25keVのGa+イオン(230pA)を照射し、試料表面にダメージ層を導入して断面TEM観察を行った結果です。観察には透過型電子顕微鏡、JEM-200CXを用いました。観察倍率は20万倍です。図より、試料表面に約23.5nmのダメージ層が形成されていることが分かります。
図2. 超低速イオンによる最終加工を行った後のSiの断面TEM像
200eVのAr+を15μA/cm2で3時間照射した
Matsutani et al., J. Surf. Anal. 7, 314 (2000).
200eVのAr+を15μA/cm2で3時間照射した
Matsutani et al., J. Surf. Anal. 7, 314 (2000).
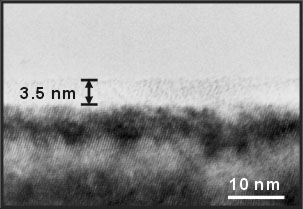
図2は、図1の試料に200eVのAr+イオンを15μA/cm2で3時間(ドーズ量は1×1018cm-2)照射した後に断面TEM観察した結果です。図1でみられた23.5nmのダメージ層3.5nm程度に減少していることがわかります。この厚さ3.5nmのアモルファス層には、Siの自然酸化膜(通常厚さ数nm)も含まれていることが予想されます。これは、超低速イオン照射後、TEM観察を行うまでに大気にさらしたためです。このことから、超低速イオンにより最終加工を行ったSi表面に存在するダメージ層は、図2に見られるよりも、実際には薄いことが予想されます。
このように超低速イオンを用いた断面TEM試料の最終加工への応用の有用性が確認されています。現在は、本手法を実際のデバイスなどの評価へ応用しています。
前ページへ
次ページへ
このように超低速イオンを用いた断面TEM試料の最終加工への応用の有用性が確認されています。現在は、本手法を実際のデバイスなどの評価へ応用しています。